If a problem occurs with the chip at the site, how can we avoid greater losses?
Case|If a problem occurs with the chip at the site, how can we avoid greater losses?The wafer packaging process is complicated and precise. If there is abnormal vibration at a station during the process, how can we stop immediately to avoid production line losses?
Packaging monitoring
Flip Chip Technology
Also known as "flip chip packaging" or "flip chip packaging method", it is a type of chip packaging technology. Flip chip packaging technology is to grow bumps at the chip connection points, and then flip the chip over to connect the bumps directly to the substrate. When the chip passes through the flip chip bonder and reflow station, if there is an unwarning situation, the product defect rate will increase.
Therefore, the factory needs to be able to intercept the signal to avoid the subsequent problems of product yield and production line downtime.

Solution and monitoring instructions
VMS-M14 dynamic monitoring system
For unwarned shutdown Understand the machine status and monitor in real time. When a problem occurs, it can send a warning signal and stop the production line to avoid greater losses in the back end.
For intelligent vision Use trend charts and data references to plan and build predictive maintenance plans to avoid maintenance at inappropriate times.
Monitoring parts and techniques Monitor the vibration value generated by the Reflow machine when the Cylinder pushes the spindle up and down to avoid the large amplitude vibration caused by the cylinder aging or spindle failure, which causes the chip and substrate to deviate when they are bonded.
Monitor the stage quality of the flip chip loading machine to avoid large vibrations caused by machine aging or machine failure, which may cause the chip and substrate to shift in position.
Measurement status
Vibration threshold determines whether it is normal
In order to determine under what circumstances to intercept the signal, the sensor is installed on the spindle before the cylinder pushes it to measure the vibration value generated when rising and falling.
The graphic features are defined as digital data to establish a big data database, and users can set the threshold value by themselves. When the vibration value exceeds the threshold, the machine can immediately intercept the signal at the first time to prevent the subsequent wafers from continuing to operate. Due to the accumulation of data and thresholds, users can obtain trend charts from the data to understand the machine condition, and further provide a reference for predicting maintenance setting points in the future.
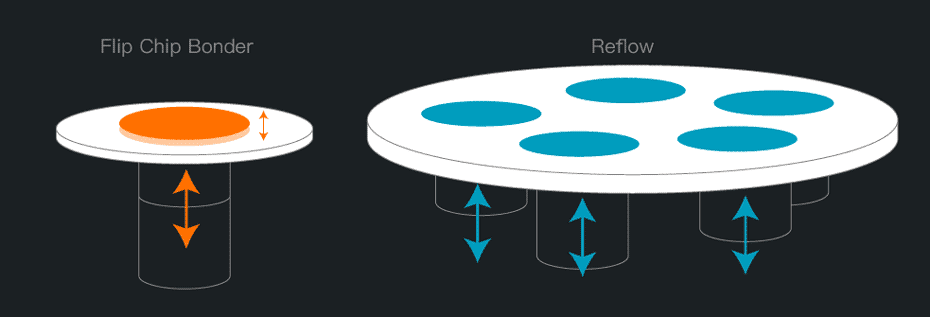

Measurement Conclusion
VMS-M14 is an intelligent monitoring system designed for the Die Bonder and Reflow combined process machines in the 2.5D process.
In the Filp chip bonding section, the flip chip machine is monitored to monitor the quality of the bonding with the product material after bonding to avoid abnormal vibration caused by machine aging or machine failure.
In the Reflow section, the dynamic vibration value generated by the specific action when the locking pneumatic cylinder or electric cylinder pushes the heating plate up and down is monitored to avoid abnormal vibration caused by aging or failure of the mechanism, which causes the material product to shift when bonding.
When the monitored dynamic vibration value exceeds the preset threshold, the machine can immediately issue an alarm. In addition, users can understand the machine condition based on the trend chart, and further provide a reference for the set point for future predictive maintenance.



